사업소개
끊임없는 연구와 기술 개발에 대한 열정을 가지고 세계로 나아가는 AP시스템
플라즈마응용기술
플라즈마를 활용하여 반도체 및 디스플레이 공정에 적용되는 증착 및 식각 장비를 보유하고 있습니다.
- 반도체 분야 : 플라즈마 증착(Sputter) 및 플라즈마 처리(Descum)
- 디스플레이 분야 : Back plane 및 TFE용 플라즈마 증착 장비(PEALD, PECVD)
- Sputter System
- Descum System
- Thin Film Encapsulation
Sputter System
KORONA™ PVD600_ Advanced Package Process
- 반도체 Advanced Package 스퍼터(Sputter)
- 반도체 소자의 대용량화, 고속화 및 소형화 추세에 따라 반도체 Package 기술도 기존 Wire bonding에서 Flip Chip 방식으로 변화되고 있으며, 최근에는
FOWLP(Fan-out wafer level package) / FOPLP(Fan-out panel level package)와 3D Package으로 발전 되어가고 있습니다. - AP시스템에서는 반도체 Package 기술의 발전에 따라 금속막 (CPB UBM, RDL) 제조용 스퍼터링 장비를 고객사에 공급하고 있습니다.
Technology
- 각 체임버로 인입 시에 Substrate Shift Detection & Align 기술
- 최적 공정 확보를 위한 저온용(-20℃) ESC 기술(@ Pre-Cleaning & Process)
- Long Term Degas Time & 균일한 High Temperature를 위한 Multi Plate Heating
System 구성기술
- Lower Particle을 위한 in Situ Pasting 기술 적용된 CCP 형태의 플라즈마 식각 체임버
- High Film Quality 및 Film Uniformity를 위한 Magnetron Sputtering Source 기술
(Magnetron Scan & Tilt for FOPLP) - 다양한 반도체 장비에 적용되어 검증된 Software Tool(EasyCluster™) 운용기술
Features
PVD600: CPB & FOWLP

- 기판 Information: Diameter 300mm including EMC (Epoxy Molding Compound)
- EFEM, 2LoadLock, Octagonal Transfer Chamber, 2Multi_Degas Chamber, 2Pre-
Cleaning Chamber (CCP) & 2Process Module

PVD600_R450: FOPLP

- 기판 Information: Rectangular(Approximately 400 x 500mm) PCB
- EFEM, 2LoadLock, Octagonal Transfer Chamber, 2Multi_Degas Chamber,
2Precleaning Chamber (CCP) & 2Process Module(Vertical Process)
Specification
| Temperature Uniformity>(@ Degas of 300℃) | ≤ 5% |
|---|---|
| Etch Uniformity(@ Precleaning) | ≤ 7% |
| Film Uniformity(@ Process) | ≤ 5% |
| Throughput(@ Ti : 1000Å, Cu : 3000Å) | ≥ 33 sheets/hr(@ Si기판), ≥ 24 sheets/hr(@ EMC & PCB 기판) |
Technology
- 각 체임버로 인입 시에 Wafer Shift Detection & Align 기술
- 최적 공정 확보를 위한 ESC 기술(@ Pre-Cleaning & Process)
- Fast Temperature Rising & 균일한 High Temperature를 위한 Dual Heating
System 구성기술
- Lower Damage & High Throughput을 위한 ICP 형태의 플라즈마 식각 체임버
- High Film Quality 및 Film Uniformity를 위한 Magnetron Sputtering Source 기술
- 다양한 반도체 장비에 적용되어 검증된 Software Tool(EasyCluster™) 운용기술
Features
PVD600: Single Backbone

- EFEM, 2LoadLock, Octagonal Transfer Chamber, Single Degas Chamber, Pre-
Cleaning Chamber (ICP) & 2Process Module
PVD1000: Dual Backbone

- EFEM, 2LoadLock, 2Octagonal Transfer Chamber, 2Single Degas Chamber,
2Precleaning Chamber (ICP) & 4Process Module
Specification
| Common | Temperature Uniformity(@ Degas of 300℃): ≤ 5% |
|---|---|
| Etch Uniformity(@ Pre-Cleaning) :≤ 5% | |
| Film Uniformity(@ Process) : ≤ 3% | |
| Throughput (@ Ti : 250Å, Al : 6000Å, TiN : 250Å) |
PVD600 : ≥ 39 sheets/hr |
| PVD1000 : ≥ 52 sheets/hr |
Descum System
KORONA™ DSC200
- 반도체 디스컴(Descum) 시스템
- 플립칩 본딩(Flip Chip Bonding)에 사용되기 위한 범프(Bump)를 웨이퍼에 형성하는 데 있어, 전기도금 공정 전 패턴 측벽의 스컴(Scum)을 제거하거나, 접착력 개선을 위한 표면을
개질하는 플라즈마 처리 시스템입니다.
Technology
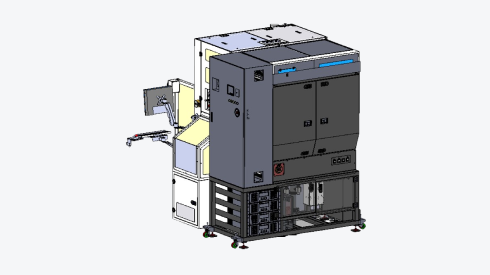
- ICP Antenna 설계 기술 (고밀도/저손상 플라즈마)
- 공정 균일도 제어 (최적화된 Pedestal 및 Edge ring 설계)
- 플라즈마 안정성 (최적화된 체임버 내부 설계)
- 기능성 반송 로봇 (웨이퍼 정렬)
Features
- 헬리컬 유도결합 플라즈마를 이용한 높은 식각률
- 대구경 플라즈마 리액터 및 최적화된 챔버 내부 구조
- 공정 균일도 제어 용이
- CoC (Cost of Consumables) 최소화
Specification
- Helical Resonance ICP Plasma(27.12MHz)
(Ion Density: >1E12 cm-3 , Electron Temperature < 1eV) - Cooling Pedestal: 0 ~ 40°C
- 각각 독립된 2 체임버로 구성된 최소화된 레이아웃(Foot print)
Thin Film Encapsulation
KORONA™ TFE System
- AMOLED 소자로의 산소 및 수분 침투 방지를 위한 봉지용 박막 구조 증착기
- 최대 6세대 2분할 기판 적용 가능
- Flexible, rollable, foldable 디스플레이 구현을 위한 유연 봉지 막 증착기
Technology

- 다중 선형 노즐의 ALD 증착 원
- In-situ cleaning 및 가스 유동 제어 기술을 통한 고청정 박막 증착 기술
- 다층구조 박막 설계 기술을 통한 stress 제어 및 투습도 최적화 기술
Features
- ICP 안테나 설계 기술 (고밀도/저손상 플라즈마)
- Susceptor 설계 기술 (후면 폴리머 제거 가능 및 웨이퍼 휨 방지)
- Pre-Heating(Halogen Lamp) 제어 및 공정 기술
- 기능성 반송 로봇 (웨이퍼 정렬)
Specification
| Substrate Loading | 6세대 2분할, 925mm x 1500mm |
|---|---|
| 기판 온도 | 최대 90℃ |
| 투습도 | <5e-5 g/m²/day @ 1000Å, SiNx/SiOx 다층구조 |
| 막 두께 균일도 | < 5% |
| 광투과도 | > 90% @ 가시광 전 영역 |
| Stress | <±100 MPa |
KORONATM ALD
(Plasma Enhanced Atomic Layer Deposition System)
- KORONATM ALD 는 플라즈마 반응을 이용하여 기존 Thermal ALD 보다 저온 공정에서 증착 가능
- Application : Active layer, Buffer layer, Encapsulation layer
Technology

- Plasma scanning 기술을 통한 대면적 증착 장비
- 노즐을 이용한 대면적 증착 장비
- Laminar flow 및 showerhead 를 이용한 대면적 증착 장비
Features
- Good step coverage
- Long PM period
- High deposition rate
- High density thin film
- High throughput
Specification
| System Configuration | 1 Process Chamber(2 Reactor) |
|---|---|
| 2 Slot Loadlock(Semi Auto Loading) | |
| Substrate Size | 730 X 920mm |
| Film Uniformity | <±3% |
| Sub. temperature | 25℃ ~ 250℃ |
| Process Pressure | 1 ~ 10 torr |
| Precursor Source | TMA, DEZ, DIPAS, DADI, TEGa, O2, Ar, N2, H2O… |
| Foot print | 1200(W)*4500(L)*2400(H) |
| Deposition | ALD(Atomic Layer Deposition) - Plasma function included |
| Control | PC Control |
KORONATM CVD
(Plasma Enhanced Chemical Vapor Deposition System)
- Micro-OLED 박막 봉지막 증착기
Technology
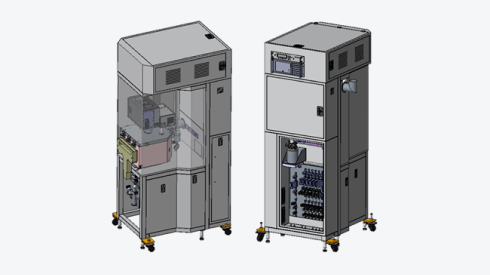
- 낮은 온도(80℃)에서 박막 봉지막 증착 가능 → OLED 소자 damage 최소화
- SiNx/SiON 박막의 우수한 투습 특성 → 봉지막 두께 최소화
- RPS(Remote Plasma System)를 사용한 cleaning 방식 적용
Features
- Excellent thickness uniformity of thin film
- Mask align
- RPS(Remote Plasma System) Cleaning
Specification
| Item | Specification | |
|---|---|---|
| Hardware | Substrate | 8 inch, 12 inch Wafer (EE : 3mm) 200 x 200mm Glass |
| Plasma source | CCP type | |
| RF generator | 13.56 MHz, 1.1 kW | |
| Substrate temperature | 80℃ ± 2℃ | |
| Base pressure | ≤ 1E-3 Torr (TBD) | |
| Process gas | SiH4, NH3, N2O, N2, H2 | |
| In-situ cleaning gas | NF3, Ar | |
| Process | Deposition material | SiNx, SiOx, SiON |
| Deposition rate | ≥3000Å/min | |
| Thickness uniformity | ≤ ± 3% | |
| Stress | ≤ ± 100 MPa | |
| WVTR | ≤ 5E-4 g/m²/day @ SiNx 1μm | |
| ≤ 5E-4 g/m2/day @ SiON 1μm | ||
| ≤ 1E-3 g/m2/day @ SiOx 1μm | ||

